
在高可靠性电子制造中,PCB 分层并不只是外观问题,而是一种结构性失效模式。它可能发生在多层板制造或PCBA 组装过程中,并进一步影响信号完整性、热稳定性以及产品的长期可靠性。
按照 IPC-A-610 标准:
起泡(Blistering):指层压基材内部,或基材与导电铜箔、保护涂层之间发生局部脱离,从而形成局部鼓包。
分层(Delamination):指基材层与层之间、基材与导电铜箔之间,或 PCB 内部其他界面之间发生分离。
PCB 出现起泡和分层,都会严重破坏其结构完整性和长期可靠性。
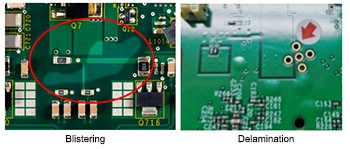
这种情况发生在铜箔与半固化片(PP)树脂的结合界面。

1) 附着力不足
铜箔与树脂的有效接触面积太小,会导致剥离强度偏低,界面更容易分离。
2)热膨胀过大
在焊接或其他热加工过程中,基材可能因膨胀超出承受范围,产生的应力会削弱结合力,最终引发分层。
这种缺陷发生在层压过程中,出现在半固化片与半固化片之间。

1)预压保温时间不足
如果过早施加全压,会导致树脂流动过度,造成缺胶,从而增加层间分离风险。
2) 预压保温时间过长
如果过晚施加全压,空气和挥发物可能无法完全排出。受热后这些空隙膨胀,容易引起分层。
3) 有污染物或异物混入
杂质会干扰树脂固化以及 PP 层之间的结合。在热应力作用下,这些薄弱界面更容易分离。
铜面经过棕化处理后,会形成一层均匀的有机金属膜微结构,有助于增强铜面与 PP 树脂之间的附着力。
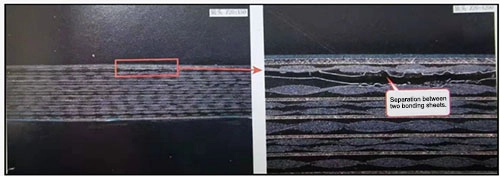
如果棕化层受损,例如表面被刮伤或处理不当,结合强度就会下降。受热膨胀应力影响后,这个薄弱界面就更容易发生分层。
PCB 分层会影响电气性能、散热能力、机械强度和长期可靠性,后果不只是外观缺陷,严重时还会导致功能失效。
High-speed signal integrity degradation caused by delamination has been discussed in industry publications such as Electronic Design.
当铜线路与介质材料分离后,可能出现以下问题:
噪声和串扰增加
阻抗发生变化
信号反射加重
间歇性开路
这些变化会降低信号完整性和整体电路性能,尤其会影响高频、高速设计。
空气的导热率远低于 FR-4 等层压材料。
分层会在板内形成空气间隙,增大热阻,使发热元件承受更大的热压力,并可能加速过热或热疲劳。
层间分离会削弱 PCB 的整体结构强度,使其更容易受到以下因素影响:
机械冲击
振动
弯曲应力
这会提高开裂、断线以及现场失效的概率。
电气不稳定、热应力和机械强度下降会共同缩短 PCB 的工作寿命,特别是在恶劣环境下更明显。
分层区域会让后续维修或返工时难以形成可靠焊点。
很多情况下,必须先去除已分离的部分,导致维修更复杂,且更容易造成二次损伤。
如果在生产阶段发现问题,受影响的板子往往需要返工或报废,直接造成损失。
若未及时发现,还可能引发:
保修索赔
产品召回
品牌声誉受损
分层会增加故障排查难度。
由于层间分离引起的电气异常可能掩盖真正根因,因此会延长诊断时间并增加停机损失。
要有效预防分层,需要从设计、材料、制造和组装几个环节协同控制。
保持铜分布均衡
避免线路尖角
保证合理间距
加入必要的热管理设计
良好的设计可以减少内部应力和不均匀热膨胀。
应选择具备以下特性的层压材料:
吸湿率低
玻璃化转变温度(Tg)高
剥离强度好
热循环性能足够稳定
材料质量会直接影响长期结合可靠性。
重点控制以下环节:
表面处理质量
压合加压时机
温度曲线
树脂流动控制
这样可以避免缺胶、空洞和界面结合不良。
湿气是 PCB 分层最常见的诱因之一。应采取以下措施:
组装前对 PCB 基板进行预烘烤,去除吸收的水分
将层压材料和成品板储存在低湿环境中
避免长时间暴露在不受控的储存条件下
降低内部水分,可以减少回流焊时因水汽膨胀带来的风险。
应按推荐的热曲线进行回流焊操作。
过度加热或升温过快,都会引起较大的膨胀应力,从而诱发分层。
建议结合以下手段:
外观检查
AOI 自动光学检测
切片分析
可靠性测试
一旦发现分层,应及时进行根因分析,并记录纠正措施,防止再次发生。
PCB 分层是一种会影响电气性能、散热能力和机械完整性的结构可靠性缺陷。
它通常由以下因素引起:
吸湿
附着力不足
压合参数不当
热膨胀应力
表面处理受损
通过优化设计、合理选材、严格控制压合工艺、做好防潮管理并规范组装流程,制造商可以显著降低分层风险,提升 PCB 的长期可靠性。
对于高性能、高可靠性应用来说,预防分层是保证产品稳定性、耐久性和品牌信誉的重要前提。