为美国和北美OEM厂商提供服务,并受保密协议保护其知识产权。

我们建造用于高密度互连板的
| 我们提供
采用符合IPC标准、RoHS/REACH要求的材料。所有项目均由我们的资深电路板工程师团队提供支持。 |
高密度互连板(或多层 HDI PCB),具有精细的线间距、微孔和焊盘内通孔,适用于细间距 BGA。
资格材料及合规性概述验收标准这些材料按照 IPC-6012 标准以及 HDI 内部标准进行了测试,例如微孔可靠性测试、热循环测试和 IIR 热循环模拟。 材料标准具有 HDI 功能的 FR-4 或低损耗材料,具有可控 CTE;可激光钻孔、与通孔填充兼容的介电材料。 结构概述采用堆叠或交错微孔、盲孔/埋孔和焊盘内过孔连接的顺序构建层。 遵守设计符合 RoHS / REACH、UL 认证和 OEM 特定 HDI 设计规则,以确保长期可靠性。 |
广科电路的PCB原型制作和批量生产服务 索取DFM指南
虽然 HDI 的裸板成本较高,但其更适合高密度布局和小型化产品设计。
| 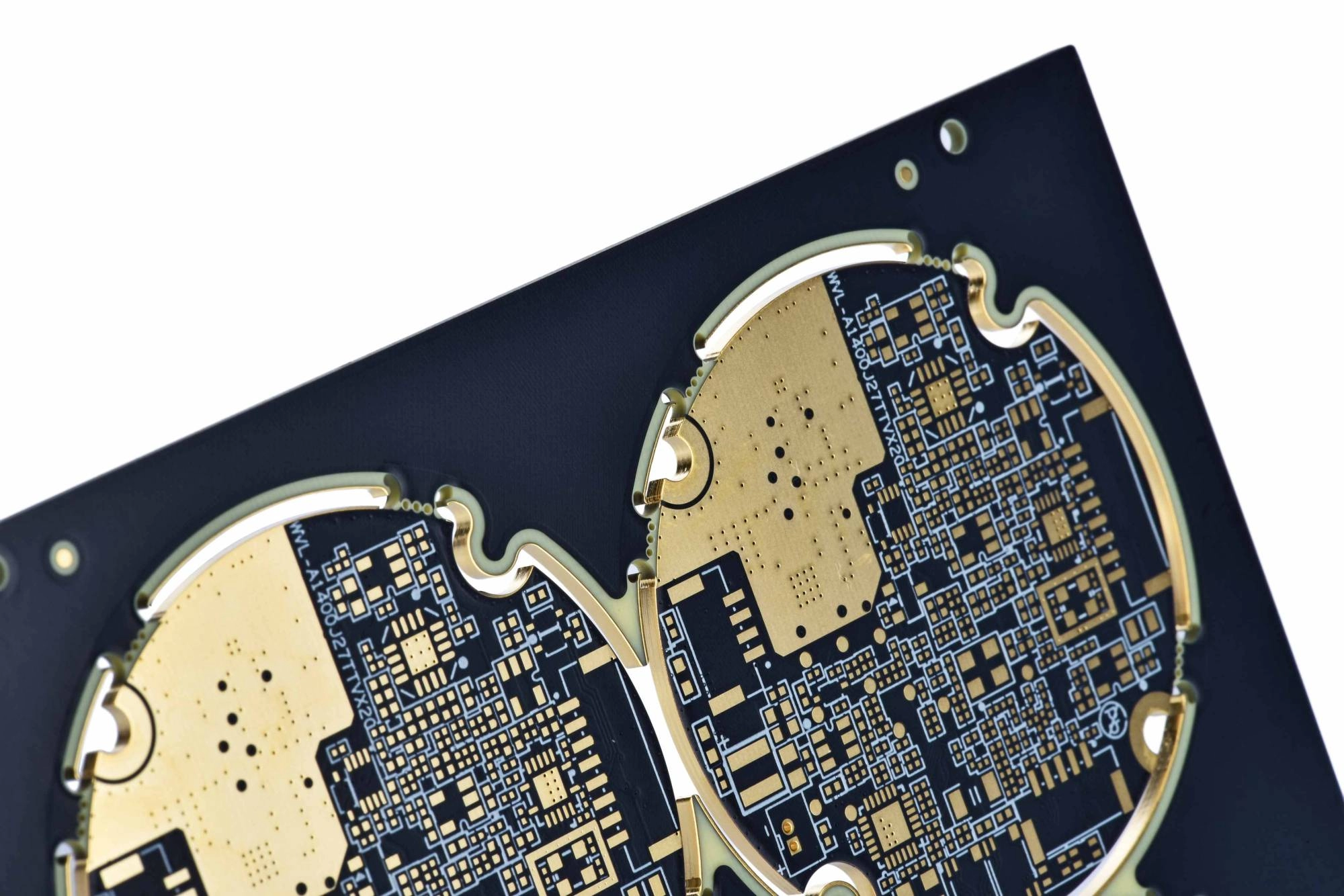 |
| HDI 还可为高速、高引脚数器件提供优异的互连质量。
|
联系广科电路定制您的HDI方案 索取DFM指南
HDI 制造需要极高的互连精度,通常达到微米级控制水平。 为满足高密度互连要求,我们采用 LDI 直接成像技术制作精细线路,利用激光钻孔形成微盲孔,并通过 X-Ray 对位系统在顺序压合前实现精准层间对位。每一层均经过 AOI 自动光学检测,确保成品具备优异的可靠性与高密度集成能力。 了解广科电路 获取HDI电路板报价 | 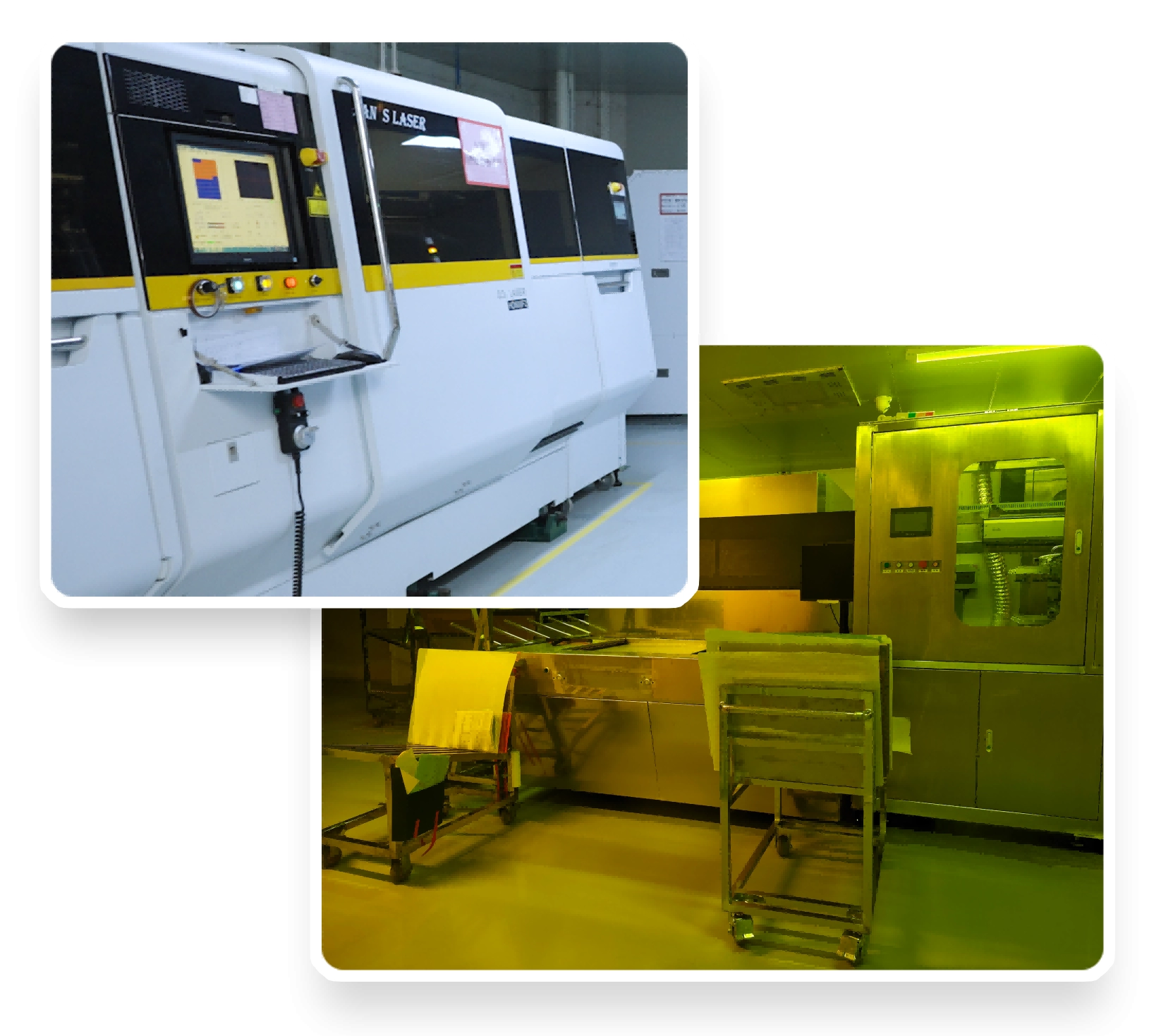 |
| 参数 | 1阶 HDI | 2阶 HDI | 3阶 HDI | 任意阶 / ELIC | 阶数变化趋势 | 参考作用 |
| HDI 堆叠结构 | 1+N+1 | 2+N+2 | 3+N+3 | 全层互连(ELIC) | 阶数 ↑ → Build-up 次数 ↑ | 层叠理解、设计基础 |
| 典型盲孔组合 | L1–L2 | L1–L3 / L(n)–L(n-2) | 多段盲孔叠加 | 任意层互通 | 阶数 ↑ → 盲孔级数 ↑ | 工艺选择 |
| Microvia 结构类型 | Staggered(推荐) | Staggered + 部分 Stacked | Stacked(多段) | 全堆叠 / 任意 | 阶数 ↑ → 叠孔比例 ↑ | 可靠性/焊接质量 |
| Via-in-Pad(垫中孔) | 可选 | 常用(BGA) | 必备(高密度) | 必须(RF/高速) | 阶数 ↑ → Via-in-Pad 必要性 ↑ | 封装设计能力 |
| Skip Via(跨层微孔) | 不建议 | 可选 | 常用 | 任意 | 阶数 ↑ → 跨层需求 ↑ | 减少通道、节省空间 |
| Build-up 材料体系 | RCC(薄介质) | RCC + PP 混用 | 多层 RCC + 高 Tg PP | 高级 RCC / mSAP | 阶数 ↑ → RCC 使用 ↑ | 介质/激光孔匹配 |
| Stack-up 介质厚度 | 75–100 μm | 50–75 μm | 50 μm | 25–50 μm | 阶数 ↑ → 介质更薄 ↑ | 激光盲孔、阻抗设计 |
| HDI DFM 规则 | 基本设计规则 | BGA fan-out 走线 | 高频/高速 DFM 限制 | 高速/高频 DFM 必须 | 阶数 ↑ → 设计规则更严格 | 可制造性、可靠性 |
| 参数类别 | 参数 | 1阶 HDI | 2阶 HDI | 3阶 HDI | 任意阶 / ELIC | 阶数变化趋势 | 参考作用 |
| 层数范围 | 总层数 | 4–8 | 6–12 (典型 8) | 8–14 (典型 10) | 12–30+ | 阶数 ↑ → 层数 ↑ | 层数/结构 |
| 板厚 | 最小板厚 | 0.005" (0.127mm) | 0.006" (0.15mm) | 0.007" (0.178mm) | 按设计 | 阶数 ↑ → 板厚略增以保证可靠性 | 层数/结构 |
| 最大板厚 | 0.200" (5mm) | 0.250" (6.35mm) | 0.300" (7.6mm) | 按设计 | 阶数 ↑ → 最大板厚 ↑ | 层数/结构 | |
| 激光孔参数 | 最小孔径 | 0.004" (0.10mm) | 0.003" (0.076mm) | 0.003" (0.076mm) | 0.05–0.15 mm | 阶数 ↑ → 孔径可更小 | 层数/结构 |
| 最大孔径 | 0.008" | 0.008" | 0.010" | 按设计 | — | 层数/结构 | |
| 深宽比 | ≤0.6:1 | ≤0.8:1 | >0.8:1 | 公式 1:(0.5+0.1×阶数) | 阶数 ↑ → 深宽比要求更严格 | 层数/结构 | |
| 机械钻孔 | 最小孔径 | 0.008" (0.20mm) | 0.008" (0.20mm) | 0.005" (0.127mm) | 按设计 | 阶数 ↑ → 钻孔精度 ↑ | 层数/结构 |
| 最大深宽比 | 10:01 | 12:01 | >20:1 | 按设计 | 阶数 ↑ → 深宽比 ↑ | 层数/结构 | |
| 线宽 / 线距 | 最小值 | 0.004" (0.10mm) | 0.003" (0.075mm) | 0.002" (0.051mm) | 基值 - (阶数×5μm) | 阶数 ↑ → 最小线宽/间距 ↓ | 材料/工艺 |
| 铜厚选项 | 内层 | 0.5–2 oz | 0.5–3 oz | 0.5–4 oz | 随阶数 ↑ → 电镀要求 ↑ | 阶数 ↑ → 内层铜厚 ↑ | 材料/工艺 |
| 外层 | 0.5–2 oz | 0.5–2 oz | 0.5–2 oz | 按设计 | — | 材料/工艺 |
| 参数类别 | 参数 | 1阶 HDI | 2阶 HDI | 3阶 HDI | 任意阶 / ELIC | 阶数变化趋势 | 参考作用 |
| 材料选项 | PCB 基材 | FR-4 / Isola 370HR | FR-4 / Isola 370HR / Rogers 4350B | FR-4 / Isola 370HR / Rogers 4350B / Megtron6 / PI | 高端 FR4 / Rogers / Polyimide | 阶数 ↑ → 材料性能 ↑ | 材料/工艺 |
| 表面处理 | Surface Finish | ENIG / OSP / HASL | ENIG / OSP / HASL / Au Selective | ENIG / OSP / ENEPIG / Soft/Hard Gold | 按设计 | 阶数 ↑ → 金手指 / 高精度镀层需求 ↑ | 材料/工艺 |
| 阻抗控制 | ±公差 | ±10% | ±10% | ±5% | ±5% (mSAP) | 阶数 ↑ → 阻抗控制公差更严格 | 功能/性能 |
| 孔铜厚度 | 埋盲孔 | ≥15 μm | ≥15 μm | ≥18 μm | 随阶数 ↑ | 阶数 ↑ → 电镀厚度 ↑ | 材料/工艺 |
| 通孔 | ≥20 μm | ≥20 μm | ≥20 μm | 随阶数 ↑ | 阶数 ↑ → 电镀厚度 ↑ | 材料/工艺 | |
| 对位精度 | 层间注册 | ±0.003" (0.076mm) | ±0.003" (0.076mm) | ±0.002" (0.051mm) | ±(25+5×阶数) μm | 阶数 ↑ → 对位精度要求 ↑ | 层数/结构 |
| 翘曲度 | Warpage | ≤1% | ≤0.8% | ≤0.7% | ≤0.5–0.7% | 阶数 ↑ → 翘曲要求 ↑ | 功能/性能 |
| 阻焊工艺 | 阻焊桥最小 | ≥0.004" (0.10mm) | ≥0.004" (0.10mm) | ≥0.003" (0.076mm) | 随阶数 ↓ | 阶数 ↑ → 阻焊桥更精细 | 材料/工艺/焊盘设计 |
| 阻焊开窗最小 | ±0.002" (0.05mm) | ±0.002" (0.05mm) | ≥0.003" (0.076mm) | 按设计 | 阶数 ↑ → 阻焊开窗更精密 | 材料/工艺/焊盘设计 | |
| 特殊工艺 | 可选电镀填孔、树脂塞孔 | 电镀填孔、树脂塞孔、LDI | 电镀填孔、树脂塞孔、LDI、嵌铜块 | ELIC、mSAP、电镀填孔、全层微孔 | 阶数 ↑ → 特殊工艺更复杂 | 材料/工艺 | |
| 电气测试 | 100% 飞针测试 | 100% 飞针测试 | 飞针 + 治具测试 | 飞针/治具 + 高压耐压 | 阶数 ↑ → 测试更严格 | 功能/性能/可靠性 | |
| 生产周期 | 标准工艺 | 7–10 天 | 10–15 天 | 14–18 天 | 按阶数+层数延长 | 阶数 ↑ → 生产周期 ↑ | 交期承诺 |
| 可靠性标准 | IPC-6012 Class 2 | IPC-6012 Class 2/3 | IPC-6012 Class 3 / AEC-Q100 | 高阶或特殊认证 | 阶数 ↑ → 可靠性标准 ↑ | 功能/性能/可靠性 |
这些常见问题解答旨在为PCB布局和硬件工程师提供贯穿整个项目生命周期的支持——从早期设计澄清和可制造性问题到生产交付、检验标准和存储条件。广科电路承担着投产工艺顾问的角色,帮助您在每个阶段平衡成本、交货时间和质量一致性。